|
|
|
 | ||
|
| ||
(Last year's presentation slides, links to talks: www.cpmt.org/scv/meetings/cpmt1310w.html). Check back around Oct. 30th for slides of the talks and links to the webcasts.
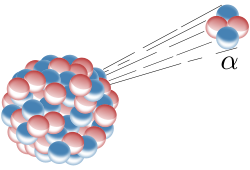 The 6th annual IEEE Santa Clara Valley SER Workshop provides a unique forum for component manufacturers, assembly houses, and electronic system manufacturers to exchange innovative ideas and recent results on the measurement, monitoring, and control of alpha emission from packaging materials and manufacturing processes.
Built on the success of our workshops held in 2009 through 2013 (with over 100 attendees), this year's event continues to cover a wide range of areas and subjects critical to the control and mitigation of device soft error rates. Talks will cover the newest updates and advances for a wide range of areas including alpha emissivity measurement techniques and processes and impact on advanced low-k devices. Speakers will come from equipment makers, component manufacturers, and academic institutions. See details of speakers and talks below. Sign up early!
The 6th annual IEEE Santa Clara Valley SER Workshop provides a unique forum for component manufacturers, assembly houses, and electronic system manufacturers to exchange innovative ideas and recent results on the measurement, monitoring, and control of alpha emission from packaging materials and manufacturing processes.
Built on the success of our workshops held in 2009 through 2013 (with over 100 attendees), this year's event continues to cover a wide range of areas and subjects critical to the control and mitigation of device soft error rates. Talks will cover the newest updates and advances for a wide range of areas including alpha emissivity measurement techniques and processes and impact on advanced low-k devices. Speakers will come from equipment makers, component manufacturers, and academic institutions. See details of speakers and talks below. Sign up early!
Please register in advance for this event, using our CPMT Chapter's EventBrite registration site.

|
YYou may register yourself, plus others from your company/institution, for either the on-site Workshop, or for the live Webinar broadcast. There is no cost. |
 PLEASE RESERVE IN ADVANCE -- through Oct. 13 (Monday)
PLEASE RESERVE IN ADVANCE -- through Oct. 13 (Monday)
| Speaker / Company | Title and Abstract of Talk |
|---|---|
| 8:30 AM - Registration opens | |
|
9:00 AM - Yi-pin Fan, TSMC |
Cell Level Soft Error Rate Simulations on Planar and FinFET Processes (PDF of slides - 400 kB)
Cell level high-energy neutron and package-related alpha SER simulations are performed for planar and FinFET based SRAM and logic cells. Compared to SER accelerated results, the simulations present accurate SER FIT rate calculations of the cells on both planar and FinFET processes. In addition, neutron-induced multiple cell upsets (MCU) of the SRAM cell are accurately simulated. The factors influencing MCU probability of the SRAM (the ratio of MCU in total upsets) on planar and FinFET processes are discussed. |
|
9:25 AM - Philippe Roche, STMicroelectronics |
Latest 3D-TCAD Simulations and Radiation Test Results in UTBB FDSOI 28nm (PDF of slides - 2.4 MB)
We will review the latest 3D-TCAD simulations and radiation test results in UTBB FDSOI 28nm. The effects of parasitic bipolar amplification will be discussed thoroughly, with a special focus on the technological parameters that affect it (back-biasing opportunities, well doping controlling the threshold voltage). As for experimental data, we will report on the extensive measurement campaigns that were carried out, allowing us to fully characterize the FD-SOI 28nm technology under radiation: neutron testing, heavy-ions, alpha particles (to which the technology proves quasi-immune), and most recently, low-energy proton and muon testing. |
|
9:50 AM - Helmut Puchner, Cypress Semiconductor |
Alpha Emission Qualification of a 361-pin Flip-Chip Package utilizing System Soft Error Testing (PDF of slides - 850 kB)
Validation of alpha emission rates for flip-chip packages is typically not possible with accelerated beam techniques. We have qualified a 361-pin flip chip package with real-life system testing in a ultra-low-neutron environment. An overall emission rate of approximately 1 alpha/khr was achieved. We will present individual alpha emission rates of the involved flip-chip component materials as well as the overall package. |
| 10:15 AM - Morning coffee break | |
|
10:30 AM - Steve Kevan, Lawrence Berkeley National Laboratory |
Keynote Talk: Soft X-ray Science and Future Generation Computing (PDF of slides - 3.5 MB)
The Advanced Light Source (ALS) at Lawrence Berkeley National Laboratory continues to play a major role in developing technologies to enable Extended Ultraviolet (EUV) lithography. Aside from shorter wavelength and larger numerical aperture optics, what lies beyond EUV? The ALS supports a world leading user program in soft x-ray science and technology, ranging form applied to purely curiosity driven research. I will discuss a emerging areas that might form the foundation for other future generation low power computing technologies - spintronics, skyrmion devices, memristors, superconductors. |
|
11:15 AM - Nathan DeBardeleben, Los Alamos National Laboratory |
Supercomputer Field Data - DRAM, SRAM, and Projections for Future Systems (PDF of slides - 350 kB)
In this presentation we will take a quick look at over 40 billion DRAM hours worth of field data from two of Department of Energy's largest supercomputers. These machines are comparable and extremely similar but one is located at Los Alamos National Laboratory (over 7,000 ft elevation) and the other is located at sea level at the National Energy Research Computing Center (NERSC, LBNL). What do these real production systems see in terms of DRAM and SRAM faults? We will show trends over a system's lifetime, look at transient and permanent errors, differences between DRAM vendors, discuss methodology, and briefly touch on what this means to next generation supercomputer projections. |
|
11:40 AM - Jehoda Refaeli, Freescale Semiconductors |
Accounting for Soft Errors with Functional Safety (PDF of slides - 1.6 MB)
The automotive semiconductor customers require ISO26262 process to be applied to parts intended for this market. This presentation will illustrate how Freescale applies ISO26262 and its relation to soft error measurements. |
| 12:05 - 1:00 PM: Lunch, exhibits, posters | |
|
1:00 PM - Mike Gordon, IBM |
The Need for an Industry-wide, Large-area, Ultra-low Emissivity Standard (PDF of slides - 900 kB)
SEU models are based in part on the measured alpha particle emissivity of the BEOL (dielectric and copper), solder bumps, molding compound, the substrate itself, and perhaps contamination from U, Th and/or their daughters. The SEU estimates will be flawed if systematic errors exist in the measurements, themselves. A large-area, ultra-low emissivity alpha particle standard is needed to ensure that the alpha particle counters in use are functioning properly. This talk will describe the need for, as well as potential materials that could be used, for such a standard. As part of the alpha particle measurement consortium, we have asked NIST to work with us to define and maintain an industry-wide standard. |
|
1:25 PM - Charlie Slayman, Cisco Systems |
Status of JEDEC Task Group on Revision of JESD89A (PDF of slides - 600 kB)
Measurement and Reporting of Alpha Particle and Terrestrial Cosmic Ray-Induced Soft Errors in Semiconductor Devices” " Since its original introduction in 2001, JESD89 has been the international standard for measuring and reporting soft error effects. It was updated in 2006. Based on research in soft errors over the past eight years, a JEDEC task group has been assembled under the JC13 and JC14 Committees to review JESD89A and recommend revisions. It is anticipated that an new revision, JESD89B, will be released in 2015. This talk will focus on the changes the task group are working on. |
|
1:50 PM - Brett Clark, Honeywell |
Characterization and Mitigation of Ambient Radon and Cosmogenic Influence on Alpha Emissivity Measurements (PDF of slides - 750 kB)
Two significant sources of measurement variability for alpha emissivity have been previously identified: cosmogenic interaction with the detector volume and ambient radon daughter decay impacting the results for several days after the start of testing. In this work, the cosmogenic component was exhaustively characterized at two locations to ascertain the correct bias factor to apply to results. To optimize measurement throughput and to eliminate ambient radon effects, a purge chamber was designed to introduce samples into the counter which had been isolated from atmospheric contact. Data describing the reduction in radon daughter impact on results will be presented. |
|
2:15 PM - Jerry Cohn, Pure Technologies |
Alpha Measurement and Control from a Supplier Perspective (PDF of slides - 1.1 MB)
In this talk we will provide a high-level overview of the purification process for metals and alloys through the removal of radioactive isotopes. We will also discuss our monitoring procedures for impurities and alpha emissivity and controls from a supplier's perspective. |
| 2:40 PM - Afternoon coffee break | |
| 2:55 PM - Panel Discussion with all on-site speakers (Host: Charlie Slaymen) |
Our speakers and industry experts will discuss critcal issues related to alpha emissivity measurments, device performance, and test methodologies for advanced Si nodes. |
| Closing at 3:30 PM | |
|
SCV Chapter
Home Page |
How to Join IEEE |
Contact our Chapter Chair |
| CPMT Society
Home Page |
IEEE Home Page |
Email
to Webmaster |
Last updated on